
中國粉體網訊 隨著5G通信、智能手機和人工智能的飛速發展,電子產品正朝著多功能集成、小型化和低成本的方向不斷邁進。這一趨勢要求不斷提高電路密度、減小集成電路間距,以此提升集成度和信號傳輸速度。在摩爾定律逐漸放緩的今天,先進封裝技術通過改變芯片連接距離和方式,成為提升芯片性能的關鍵力量。其中,2.5D轉接板封裝技術作為2D和3D封裝之間的過渡方案,正受到越來越多的關注。
從2D到3D:封裝技術的演進與挑戰
傳統的2D系統級封裝在走線方面存在明顯局限,容易導致產品帶寬有限、體積較大,難以滿足高性能設備的需求。而3D硅封裝技術雖然具備低功耗、帶寬寬的優勢,卻因成本過高,在工藝研發、可靠性設計和散熱設計等方面面臨諸多挑戰,大規模應用受到限制。
為了平衡性能與成本,2.5D封裝技術應運而生。它通過將多種芯片與器件裝配在中介層上,利用走線實現芯片間水平與垂直信號的相互連接,既突破了2D封裝的性能瓶頸,又避開了3D封裝的高成本難題。中介層作為2.5D封裝的核心,按材料可分為有機、玻璃、陶瓷和硅中介層四類,不同材料的特性直接影響著封裝技術的表現。
不同中介層材料的比拼
有機中介層以有機樹脂和玻璃纖維為主要材料,制造成本低、工藝流程簡單,但散熱性較差,且隨著層數增加,翹曲問題會愈發嚴重,難以應用于高性能產品領域。
目前,硅中介層技術相對成熟穩定,已在生產中大量應用。但它存在明顯短板,在高頻條件下,信號串擾和插損顯著,導致可靠性下降,且價格較高,限制了其應用范圍。
陶瓷中介層采用AlN和Al₂O₃等陶瓷材料,具備優良的絕緣性和機械性能,其中AlN陶瓷還具有低熱膨脹系數、高電阻和高導熱性等優勢。然而,陶瓷材料加工需要靜壓粉末壓制,不僅成本高昂,效率也很低,大規模生產困難。
在這樣的背景下,玻璃中介層逐漸走進人們的視野。尤其是玻璃通孔(TGV)技術,作為硅通孔(TSV)的替代方案,被視為下一代3D集成的核心技術,展現出巨大的發展潛力。
玻璃材料之所以能成為中介層的理想選擇,源于其獨特的物理和化學特性。它是一種透明材料,便于加工過程中內部結構的檢查和光學連接;具有良好的熱穩定性,在高溫下不易變形;表面平整度高,能夠形成高密度的通孔和信號走線;且熱膨脹系數可調節,能根據特定產品要求選擇合適性能的玻璃材料。
玻璃中介層的實踐與應用
近年來,國內外科研機構和企業在玻璃中介層技術的研發與應用上取得了一系列成果。
2019年,IWAI等專家利用多層玻璃基板技術制作多芯片封裝系統,通過激光誘導玻璃變性、濕法刻蝕等技術形成種子層,再結合半加成法工藝設計走線方案,最終實現了多芯片組件的裝配。
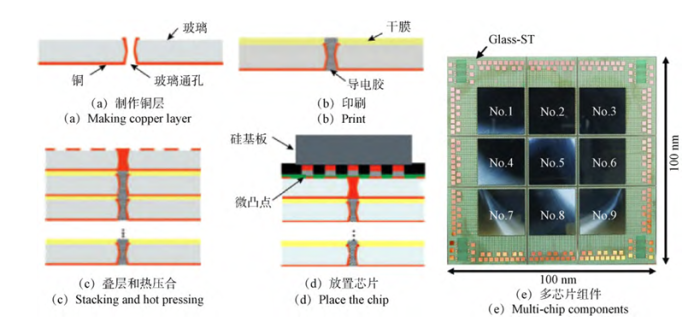
多芯片封裝系統工藝流程以及基于玻璃基板的多芯片組件 來源:IWAI.Multilayer glass substrate with high density via structure for all inorganic multi-chip module
2020年,廈門云天半導體科技公司開發的77GHz汽車雷達芯片組件,采用嵌入式玻璃扇出技術,在180μm厚的玻璃晶圓中制作玻璃腔,將芯片嵌入其中,有效保護了芯片底部,提升了封裝性能。
2024年,電子科技大學成功開發出采用系統級封裝技術和TGV工藝的超寬帶雙頻段射頻T/R微系統,通過堆疊六層無堿玻璃實現多層結構,進一步拓展了玻璃中介層在高性能微系統中的應用。
結語
在電子產品不斷追求高性能、小型化的浪潮中,2.5D封裝技術扮演著承上啟下的重要角色。而玻璃中介層憑借其優異的高頻性能、良好的絕緣性、可調節的熱膨脹系數以及相對較低的成本,正逐漸成為2.5D封裝技術的核心選擇。隨著相關工藝的不斷成熟和創新應用的持續涌現,玻璃中介層有望在未來的先進封裝領域發揮更加關鍵的作用,為電子設備的性能突破提供有力支撐。
參考來源:
謝迪.基于TGV工藝的三維集成封裝技術研究
劉德喜.TGV技術在微波領域的應用與挑戰
盧茜.玻璃基三維集成技術在寬帶射頻領域的應用
IWAI.Multilayer glass substrate with high density via structure for all inorganic multi-chip module
(中國粉體網編輯整理/月明)
注:圖片非商業用途,存在侵權告知刪除!














