
中國粉體網(wǎng)訊 在5G、人工智能、高性能計算等技術(shù)迅猛發(fā)展的當下,全球半導體產(chǎn)業(yè)正經(jīng)歷新一輪技術(shù)變革與產(chǎn)能競賽。其中,先進封裝領(lǐng)域成為競爭焦點,傳統(tǒng)有機基板逐漸逼近物理極限,而玻璃基板憑借優(yōu)異平整度、高熱穩(wěn)定性、低信號損耗等特性,成為下一代高密度封裝的核心材料,受到行業(yè)廣泛關(guān)注。
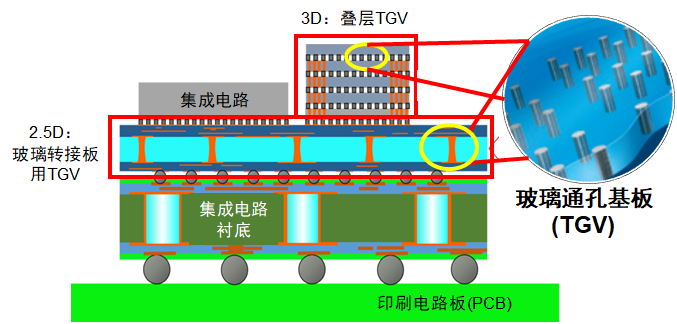
先進封裝TGV示意圖 來源:中國建筑材料科學研究總院
近日,國內(nèi)電子玻璃龍頭企業(yè)東旭集團宣布成功完成首批TGV(玻璃通孔)相關(guān)產(chǎn)品開發(fā)并向下游客戶送樣,產(chǎn)品覆蓋6寸、8寸、12寸晶圓級規(guī)格及510×515mm板級產(chǎn)品,多項關(guān)鍵技術(shù)指標達國際一流水平。
作為2.5D/3D先進封裝的核心,TGV技術(shù)憑借顛覆性的性能優(yōu)勢,成為突破芯片性能瓶頸的關(guān)鍵。東旭集團依托在電子玻璃領(lǐng)域深厚的技術(shù)積淀,向下游延伸,在TGV技術(shù)上成功破解傳統(tǒng)封裝瓶頸,實現(xiàn)全方位突破。其獨創(chuàng)的激光誘導刻蝕打孔技術(shù),配合定制刻蝕液,能實現(xiàn)通孔圓度≥95%、孔徑≥20μm、深徑比10:1,粗糙度控制在1nm以下,且孔型可靈活實現(xiàn)X型孔與垂直孔,在鍍銅環(huán)節(jié),采用雙面垂直電鍍技術(shù),銅層結(jié)合力>5N/cm,種子層連續(xù)無斷點,確保了卓越的電氣連接性能。
目前,全球封裝玻璃基板市場雖處于起步階段,但已吸引眾多國際巨頭搶先布局。英特爾、三星、英偉達、AMD等紛紛加碼玻璃基板研究,連蘋果也在和供應商探討應用可能。據(jù)Prismark統(tǒng)計數(shù)據(jù),到2026年全球IC封裝基板市場規(guī)模將達214億美元,而玻璃基板的滲透率可能在3年內(nèi)達到30%,5年內(nèi)超過50%,發(fā)展速度驚人。
早在多年前,東旭便前瞻性啟動“屏芯協(xié)同”戰(zhàn)略,致力于推動顯示玻璃與半導體材料領(lǐng)域的雙向賦能與技術(shù)融合。此次TGV相關(guān)產(chǎn)品的成功開發(fā),不僅是企業(yè)在半導體材料領(lǐng)域的關(guān)鍵技術(shù)突破,為自身開辟了新的增長空間,更向行業(yè)釋放積極信號,為中國半導體材料的國產(chǎn)替代進程注入強勁動力。
作為國內(nèi)電子玻璃領(lǐng)域的領(lǐng)軍企業(yè),東旭的技術(shù)實力與行業(yè)地位早已得到認可,其液晶玻璃基板、高端蓋板玻璃技術(shù)穩(wěn)居全球前列,還曾斬獲“國家科學技術(shù)進步獎”“中國專利金獎”等多項國家級榮譽。依托深厚的技術(shù)積累,東旭進一步打通產(chǎn)業(yè)鏈上下游,構(gòu)建起“材料研發(fā)-生產(chǎn)制造-封裝應用”的全鏈條能力,為TGV技術(shù)從實驗室研發(fā)走向規(guī)模化量產(chǎn)提供了堅實支撐。
面向未來,東旭明確表示,將持續(xù)加大研發(fā)投入,加速TGV等相關(guān)產(chǎn)品的迭代優(yōu)化,并推動其在更多半導體應用場景中落地,同時,將深化與芯片設計、封裝測試等產(chǎn)業(yè)鏈環(huán)節(jié)的協(xié)同創(chuàng)新,以“屏芯協(xié)同”戰(zhàn)略為紐帶,持續(xù)助力中國半導體產(chǎn)業(yè)鏈的整體升級。
參考來源:
東旭集團、中國建筑材料科學研究總院、中國經(jīng)濟網(wǎng)
廣發(fā)證券《玻璃基板從零到一,TGV為關(guān)鍵工藝》
(中國粉體網(wǎng)編輯整理/月明)
注:圖片非商業(yè)用途,存在侵權(quán)告知刪除!














